-
 富睿思原子力显微镜与白光轮廓仪原位联用系统AFM-WLI Duet,为用户提供便捷的跨尺度形貌表征方案2025-09-08
富睿思原子力显微镜与白光轮廓仪原位联用系统AFM-WLI Duet,为用户提供便捷的跨尺度形貌表征方案2025-09-08AFM-WLI Duet 是富睿思桌面型超薄测头原子力显微镜AFM-Piccolo与白光轮廓仪WLI-Marimba(Linnik型)的同轴集成系统。AFM-Piccolo的测头设计独具匠心,其有效厚度小于8 mm,加上底座部分其厚度小于10 cm,非常便于与包括白光轮廓仪(WLI)在内的其它设备进行联用。WLI-Marimba(Linnik型)的设计,可以使白光轮廓仪有很大的工作距离,完美适配AFM-Piccolo的桌面型超薄测头。

在某些应用场景下,用户既需要大尺度快速测量结果,又需要小尺度高分辨测量结果,AFM-WLI Duet便可以为用户提供便捷的跨尺度测量方案,它分别使用白光干涉技术和原子力显微技术实现快速大范围测量和小范围高分辨测量,AFM和WLI二者的结合可为用户提供便捷的原位跨尺度形貌表征方案。
以下为大家介绍一下使用富睿思原子力显微镜和白光轮廓仪联用的测试案例。
图1是采用AFM-WLI Duet测试回字形栅格的测试结果,Visual Image是直接用光学显微镜观察到的图像,可以看到图像中的回字形栅格和探针悬臂及基底部分,在该图像中选取中心回字区域进行WLI成像,如蓝绿图像所示,成像范围为550 μm,红色section图像代表回字栅格高度差截面图,在该图像中选取回字凸起部分进行AFM成像,如黄褐色图像所示,成像范围为50 μm,蓝色section图像代表栅格高度差截面图,台阶高度约为105 nm,和白光轮廓仪的测试数据具备一致性。

图1:回型栅格扫描图像
图2是使用AFM-WLI Duet对静态随机存取存储器(Static Random-Access Memory,SRAM)进行测试得到的图像,左侧蓝色图像代表了SRAM的WLI成像图像,成像范围为500 μm,图中红色部分为AFM探针悬臂,右侧为AFM测试的形貌图图像,扫描范围为20 μm。测试过程中先对SRAM进行大范围的WLI成像,然后选取感兴趣的微区,使用AFM探针定位下针进行小尺度扫描。

图2:SRAM扫描图像
-
 原子力显微镜(AFM)的精确表征助力碳化硅(SiC)表界面的微观观察2025-07-10
原子力显微镜(AFM)的精确表征助力碳化硅(SiC)表界面的微观观察2025-07-10碳化硅(Silicon Carbide,SiC)是一种宽禁带半导体材料,因其优越的物理和电学特性,在现代半导体产业中扮演着越来越重要的角色,特别是应用在高压、高频、高温、高功率等极端环境下的电子器件中。同时,由于SiC材料和器件表面形貌、晶体质量、粗糙度等参数对其性能有显著影响,原子力显微镜(AFM)作为纳米级表面分析工具,在SiC相关研究和生产中具有不可替代的重要性。
尽管SiC具备卓越的电学和热学性能,但其材料制备、晶体生长、表面处理、器件加工等环节面临诸多挑战,如表面粗糙度控制、外延层质量、晶体缺陷等问题。因此,要充分发挥SiC的优异性能,必须对其材料质量、表面状态、加工精度进行严格把控。AFM作为一种高分辨率、非破坏性的表面测量和分析工具,已逐渐成为SiC材料与器件研发、生产与质量控制中不可或缺的利器。通过AFM的精确表征,科研人员与工程师能够深入理解SiC表界面的微观世界,持续推动SiC半导体技术向更高性能、更高可靠性迈进。
如下图所示,这是一张富睿思原子力显微镜(AFM)的扫描结果,扫描范围为500 nm的SiC原子台阶图像,台阶高度约为0.75 nm。
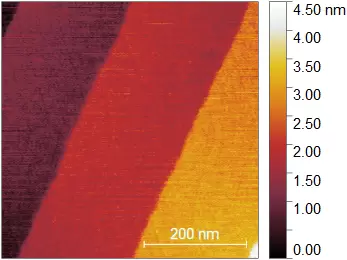
如下图所示,这是一张使用富睿思原子力显微镜(AFM)扫描SiC表面得到的图像,扫描范围为10 μm,C面的粗糙度为0.72 nm。

-
 原子力显微镜(AFM)在LTPS生产制造与质量控制中的关键作用2025-06-24
原子力显微镜(AFM)在LTPS生产制造与质量控制中的关键作用2025-06-24LTPS(Low Temperature Polycrystalline Silicon,低温多晶硅)是一种用于制造薄膜晶体管(TFT)的技术,广泛应用于现代显示面板行业,特别是在高端中小尺寸显示器件中,如智能手机、平板电脑、车载显示器、高端笔记本电脑以及新兴的柔性显示和AMOLED屏幕中。
原子力显微镜(AFM)在LTPS技术的研究与生产测试过程中,扮演着不可或缺的角色。这主要是因为LTPS的核心在于其多晶硅薄膜的表面形貌、晶粒结构、结晶质量、电学特性分布等微观特性,而这些特性直接影响TFT器件的性能,如迁移率、阈值电压、均匀性和可靠性。均匀的晶粒有利于提高电子迁移率;表面粗糙度会影响后续栅极绝缘层、源漏极等工艺的均匀性与界面质量;晶界如有缺陷会影响载流子迁移和器件一致性;结晶缺陷和孔洞会影响TFT的电学稳定性和寿命。
AFM作为一种超高分辨率、非破坏性的表面形貌与材料特性分析工具,能够对表面粗糙度、晶粒大小与分布、晶界密度与取向、结晶缺陷与孔洞等这些微观特征进行纳米级甚至原子级的表征,为以LTPS为代表的面板行业中工艺优化、缺陷分析、机理研究及产品良率提升提供关键数据支撑。
以下就以两幅LTPS的AFM扫描图像为例,为大家展示富睿思原子力显微镜(AFM)测量效果。下面两幅图是晶向略有差异的扫描范围均为5 μm的LTPS晶粒图像,两幅图的粗糙度约为10 nm,晶粒分布均匀,无明显缺陷,晶粒尺寸约为150 nm。

图1:LTPS表面晶粒晶向图像

图2:LTPS表面晶粒晶向图像
-
 从h-BN的表面形貌到表面电势,揭示原子力显微镜(AFM)在二维材料领域的强大应用2025-05-06
从h-BN的表面形貌到表面电势,揭示原子力显微镜(AFM)在二维材料领域的强大应用2025-05-06二维材料(2D Materials)作为21世纪材料科学的重要突破之一,以其独特的结构和优异的性能,在电子、能源、传感、光电子、医疗、环境等领域展现出革命性的应用潜力。尽管目前仍面临制备、稳定性、集成等多方面的挑战,但随着技术的不断进步和研究的深入,二维材料有望在未来几十年内推动多个行业的技术革新,成为构建下一代智能、柔性、高效器件的核心基础材料。
石墨烯(Graphene)、过渡金属二硫化物(如MoS₂)、黑磷(BP)、六方氮化硼(h-BN)、MXene、二维过渡金属碳/氮化物等都是二维材料的典型代表。AFM凭借其高空间分辨率、多模态测量能力、对样品的低损伤性以及在多种环境下的适应性,在二维材料的基础研究、性能表征和器件应用探索中,发挥着核心作用,尤其是在厚度测量、表面形貌、纳米力学、纳米电学特性和异质结构分析等方面,AFM是最为关键的表征手段之一。
以下以h-BN为例,为大家介绍采用富睿思原子力显微镜测试的二维材料的典型结果。如下图所示,是扫描范围为10 μm的六方氮化硼(h-BN)的形貌图像和表面电势图像,从形貌图像中可以分析出该h-BN单层的厚度约为0.3 nm,平整处表面粗糙度约为0.4 nm,表面电势图像中可以明显地看到经过特殊处理的h-BN内部表面电势的不规则分布。通过对h-BN厚度、表面粗糙度、表面电势的分析可以为层数对电子及晶格结构的影响、掺杂效应引起的局域功函数变化提供直观的数据支撑。

h-BN表面形貌图像(纵坐标单位:nm)

h-BN表面电势图像(纵坐标单位:mV)



