知识中心
案例展示
碳化硅(Silicon Carbide,SiC)是一种宽禁带半导体材料,因其优越的物理和电学特性,在现代半导体产业中扮演着越来越重要的角色,特别是应用在高压、高频、高温、高功率等极端环境下的电子器件中。同时,由于SiC材料和器件表面形貌、晶体质量、粗糙度等参数对其性能有显著影响,原子力显微镜(AFM)作为纳米级表面分析工具,在SiC相关研究和生产中具有不可替代的重要性。
尽管SiC具备卓越的电学和热学性能,但其材料制备、晶体生长、表面处理、器件加工等环节面临诸多挑战,如表面粗糙度控制、外延层质量、晶体缺陷等问题。因此,要充分发挥SiC的优异性能,必须对其材料质量、表面状态、加工精度进行严格把控。AFM作为一种高分辨率、非破坏性的表面测量和分析工具,已逐渐成为SiC材料与器件研发、生产与质量控制中不可或缺的利器。通过AFM的精确表征,科研人员与工程师能够深入理解SiC表界面的微观世界,持续推动SiC半导体技术向更高性能、更高可靠性迈进。
如下图所示,这是一张富睿思原子力显微镜(AFM)的扫描结果,扫描范围为500 nm的SiC原子台阶图像,台阶高度约为0.75 nm。
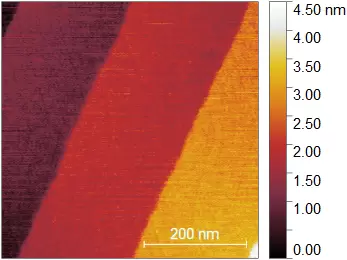
如下图所示,这是一张使用富睿思原子力显微镜(AFM)扫描SiC表面得到的图像,扫描范围为10 μm,C面的粗糙度为0.72 nm。
